中国科学院物理研究所
北京凝聚态物理国家研究中心
E03组供稿
第41期
2017年09月07日
纯n型III族氮化物半导体异质结构实现p-n结整流特性
GaN基材料(主要包括GaN,以及与InN,AlN的合金)由于其大范围可调节的直接禁带,饱和电子迁移速度大,击穿场强高等优异的性能,已经成为高频大功率光电和电子器件领域的重要材料。其中通过对半导体材料的p型和n型掺杂以形成的p-n结是许多器件的核心结构之一。然而,由于p型GaN空穴浓度低,电子迁移率小,低效率的GaN的PN结也成为阻碍这些器件的发展的原因之一。
近期,中国科学院物理研究所/北京凝聚态物理国家实验室(筹)的E03组的博士生左朋以及江洋、王禄、马紫光副研究员在陈弘研究员的指导下,与刘伍明研究员课题组以及首都师范大学 纪安春教授合作,利用材料的极化特性,在纯n型GaN/(Al,Ga)N/GaN双异质结中插入InGaN量子阱,观察到正向和反向导通的显著差异,成功实现了p-n结整流特性。
如图1(a)所示,当InGaN 插入层在AlGaN势垒层下方时,由于 InGaN层存在压电极化,InGaN 量子阱能级倾斜,这诱导了 InGaN/GaN 界面势垒的形成;同时电子从 AlGaN/GaN 界面沟道向 InGaN 量子阱的扩散,因而 GaN spacer 的能级抬高形成阻挡电子扩散的势垒。这两个势垒增强了AlGaN/GaN界面沟道对电子的限制作用,导致沟道中的电子浓度增加,从而降低正向开启电压。同时,InGaN插入层离AlGaN势垒层的距离(GaN spacer的厚度)对电学性质有直接的影响,如图1(c)所示,当 GaN spacer层厚度为15 nm 时,样品展示了高达-10.6 V的反向开启电压,样品在±1.8 V 时的整流比(RR)高达 8.2×104。
为解释上述整流特性,项目组结合热电子发射理论对样品的I-V关系进行了理论拟合,计算了带有InGaN量子阱插入层的异质结样品在不同偏压下的能带结构(如图2(a)),样品的理论曲线与实验 I-V 关系拟合的很好。在反向偏压的情况下,外场方向与 InGaN 量子阱之中的极化场方向相反,这在一定程度上削弱了 InGaN/GaN 界面势垒,压制了 GaN spacer 的能带的抬高,外加电压有一部分要落在 InGaN 量子阱相关区域(V3),落在 GaN 电子耗尽区的电压降V1的减少以及耗尽区势垒V-=VB-∣V1∣的增加,异质结系统中的反向热发射电流\(I\_={\rm A\_exp}(-\frac{qV\_}{h\_kT})\)被压制,导致反向开启电压变大。 在正向偏压的情况下,外场方向与 AlGaN 势垒层中极化场方向相反,降低了AlGaN 势垒的高度,同时 InGaN/GaN 界面势垒较薄,电子可以隧穿方式通过,正向电流主要是被 AlGaN势垒限制,正向热发射电流大小为\(I_{+}={\rm A_{+}exp}(-\frac{qV_{+}}{h_{+}kT})\),主要取决于 A+与 V+,InGaN 量子阱的插入提高了 AlGaN/GaN 界面电子沟道对电子的限制作用,大大提高了 A+(约 1.81 mA),因而正向开启电压降低。
上述发现避免了GaN材料中低效p型掺杂的问题,对于未来制造新型的HBT,IGBT以及其他新型电子器件提供了可能;同时这种方法对其他具有极化特性的半导体材料系(如ZnO基材料)实现整流特性也具有重要参考意义。该工作发表于Phys. Rev. Applied 8, 024005 (2017)。
该项研究工作得到了国家自然科学基金委(11574362, 61210014, 11374340, 11474205)、北京市科技计划(Z151100003515001)的资助,其中器件研制工作得到了微加工实验室顾长志研究组的大力支持。
近期,中国科学院物理研究所/北京凝聚态物理国家实验室(筹)的E03组的博士生左朋以及江洋、王禄、马紫光副研究员在陈弘研究员的指导下,与刘伍明研究员课题组以及首都师范大学 纪安春教授合作,利用材料的极化特性,在纯n型GaN/(Al,Ga)N/GaN双异质结中插入InGaN量子阱,观察到正向和反向导通的显著差异,成功实现了p-n结整流特性。
如图1(a)所示,当InGaN 插入层在AlGaN势垒层下方时,由于 InGaN层存在压电极化,InGaN 量子阱能级倾斜,这诱导了 InGaN/GaN 界面势垒的形成;同时电子从 AlGaN/GaN 界面沟道向 InGaN 量子阱的扩散,因而 GaN spacer 的能级抬高形成阻挡电子扩散的势垒。这两个势垒增强了AlGaN/GaN界面沟道对电子的限制作用,导致沟道中的电子浓度增加,从而降低正向开启电压。同时,InGaN插入层离AlGaN势垒层的距离(GaN spacer的厚度)对电学性质有直接的影响,如图1(c)所示,当 GaN spacer层厚度为15 nm 时,样品展示了高达-10.6 V的反向开启电压,样品在±1.8 V 时的整流比(RR)高达 8.2×104。
 |
| 图1(a)GaN/Al0.15Ga0.85N/GaN spacer/In0.2Ga0.8N/GaN和无InGaN量子阱插入层结构的能带图。(b)不同GaN spacer厚度样品的能带图。(3)I-V特性曲线。 |
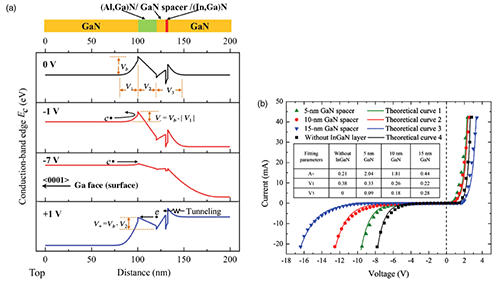 |
| 图2(a)n-GaN/AlGaN/GaN/InGaN/n-GaN 异质结样品在不同偏压下的导带图 (b)样品的 I-V 关系(散点)与理论拟合曲线 |
该项研究工作得到了国家自然科学基金委(11574362, 61210014, 11374340, 11474205)、北京市科技计划(Z151100003515001)的资助,其中器件研制工作得到了微加工实验室顾长志研究组的大力支持。

